随着半导体工艺的不断进步,芯片集成度呈指数级增长,测试成本与测试效率已成为行业面临的核心挑战。传统依赖外部自动测试设备(ATE)的方法不仅费用高昂,且难以覆盖芯片内部大量不可直接访问的电路节点。逻辑内建自测试(LBIST)技术 应运而生,它通过将测试电路植入芯片内部,使芯片能够对自身逻辑电路进行自主检测,显著降低了对ATE的依赖,在汽车电子、航空航天等高可靠性领域成为关键技术。
LBIST的基本概念与背景
LBIST全称为Logic Built-in Self-Test,即逻辑内建自测试,是一种在芯片设计阶段集成到电路中的专用测试结构,旨在对芯片内部的逻辑电路 进行自主检测。其核心理念是将测试功能内嵌于芯片设计之中,使芯片像拥有“免疫系统”一样,在出厂后甚至服役期间能够自行进行“体检”,及时发现制造缺陷或老化故障。
与传统测试方法相比,LBIST解决了多个挑战:首先,它降低了对昂贵ATE设备的依赖;其次,它能够覆盖那些没有直接连接到外部引脚的嵌入式逻辑节点;此外,它支持接近芯片实际工作频率的高速测试,这是许多ATE设备难以实现的。

LBIST与存储器内建自测试(MBIST)共同构成了BIST技术的两大支柱,但LBIST专注于数字逻辑电路的测试,包括处理器核心、组合逻辑、时序逻辑等。与MBIST针对存储器的特定测试算法 不同,LBIST主要采用伪随机测试向量生成与响应分析技术,以适应数字逻辑电路的多样性和复杂性。
LBIST的工作原理与核心架构
LBIST的实现依赖于一套精心设计的硬件架构和系统化的工作流程。其核心组件包括伪随机模式生成器(PRPG)、扫描链、多输入签名寄存器(MISR)以及BIST控制器。
PRPG通常基于线性反馈移位寄存器(LFSR)生成伪随机测试序列,作为测试激励的源头;为了增强随机性,有时还会加入移相器。扫描链是连接PRPG与被测逻辑的通道,在测试模式下,芯片内部的寄存器被重新配置为串行移位链路,使测试向量能够高效加载到内部,同时将响应结果捕获并传出。MISR负责将大量的输出响应压缩成一个固定的“签名”,与预先计算的无故障电路签名进行比对,从而判断测试通过与否。BIST控制器则作为整个系统的“大脑”,协调测试的启停、模式切换、结果比对和状态报告。
LBIST的测试过程遵循严谨的序列:
- 初始化:控制器接收启动信号,切换芯片到测试模式,扫描链复位,PRPG加载初始种子,MISR清零。
- 向量加载与应用:PRPG生成的伪随机测试向量通过扫描链加载到被测逻辑的输入寄存器,并应用功能时钟周期使向量在被测逻辑中传播。
- 响应捕获与压缩:输出响应被捕获到输出寄存器,然后通过扫描链移位到MISR中进行压缩,这一过程重复进行直到生成足够数量的测试向量。
- 结果比对与恢复:MISR产生的最终签名与预存的“黄金签名”比对,控制器根据比对结果生成Pass/Fail信号,并切换芯片回正常工作模式。
整个过程中,LBIST利用芯片自身的时钟和资源实现了高速测试,有助于检测仅在高频下出现的时序故障。在实际芯片如英飞凌TC3xx系列中,LBIST执行完成后通常会触发系统热复位,然后软件在启动过程中检查测试结果。
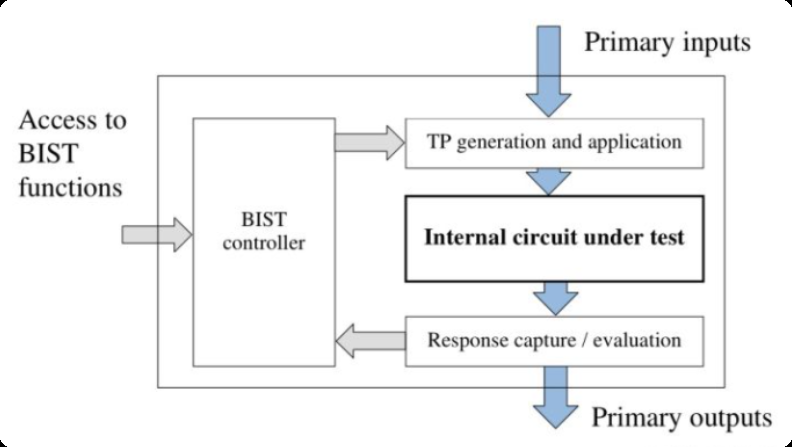
LBIST的技术优势与局限性
LBIST之所以在高端芯片中得到广泛应用,是因为它解决了传统测试方法的多个痛点。其核心优势体现在以下几个方面:
- 显著降低测试成本:传统ATE设备价格昂贵,且测试时间随电路复杂度增加而线性增长,LBIST通过将测试功能内置,减少了对昂贵ATE设备的依赖,特别适合大规模量产芯片的测试。
- 实现真正的高速测试:LBIST使用芯片的功能时钟进行测试,能够检测出仅在高频下出现的时序故障,这对于现代高速芯片至关重要。
- 支持现场自检与持续监控:LBIST不仅用于制造测试,还能在芯片现场运行期间进行定期健康检查,符合ISO 26262等功能安全标准的要求。
- 解决不可达节点测试难题:对于没有直接连接到外部引脚的嵌入式逻辑模块,LBIST通过内部测试结构实现了深度覆盖。
- 面积效率高:与MBIST通常需要3%-5%的面积开销相比,LBIST通过复用芯片已有的扫描链等DFT资源,面积开销通常可控制在1%以下。
然而,LBIST也存在一些技术挑战和局限性。
- 测试覆盖率存在盲点:由于采用伪随机测试向量,LBIST对某些特定故障(如某些桥接故障、冗余逻辑故障)的覆盖率可能不足,虽然可以通过加权LFSR、测试点插入等技术缓解,但难以完全消除。
- 面积与功耗开销:尽管相对面积开销较小,但LBIST仍需额外的测试电路,且测试期间功耗通常高于正常功能模式,可能影响测试稳定性。
- 测试时间较长:为了达到足够的故障覆盖率,LBIST需要生成大量伪随机测试向量,对于复杂逻辑,测试时间可能达到毫秒级,成为瓶颈。
- 诊断能力有限:MISR的响应压缩过程会丢失原始响应信息,使得故障精确定位困难,通常需要额外诊断技术。
- 设计复杂度增加:LBIST插入需要额外的设计和验证工作,增加了设计流程的复杂度。
为应对这些挑战,业界已开发出混合LBIST(结合伪随机向量与确定性向量)和选择性LBIST(针对关键逻辑实施测试)等方法,以平衡覆盖率、开销与测试时间。

LBIST的实际应用场景
LBIST因其独特优势,在多个对可靠性和安全性要求极高的领域找到了广泛应用。
在汽车电子领域,尤其是发动机控制、高级驾驶辅助系统(ADAS)等安全关键应用中,LBIST是满足ISO 26262功能安全标准要求的关键技术。以英飞凌TC3xx系列芯片为例,LBIST被用于检测MCU内部逻辑电路的潜伏故障,支持上电自检和周期性自检两种模式,确保在检测到潜在故障时系统能及时进入安全状态。
在高可靠性计算场景中,如航空航天、工业控制和医疗设备,芯片需在恶劣环境下长期稳定运行,定期执行的LBIST能够及时检测辐射等因素引起的瞬态故障,确保系统可靠性,其测试结果还可用于系统健康预测。
在现代高性能处理器与AI加速器中,LBIST解决了传统测试方法难以应对的挑战。这些芯片通常包含深流水线、非规则逻辑结构以及手工优化电路,传统扫描测试覆盖率低且测试模式数量爆炸式增长。而LBIST的伪随机测试特性特别适合这类复杂逻辑的测试需求。例如,在AI加速器中,LBIST可以并行测试高度并行的计算单元,显著缩短测试时间,同时其高速测试能力确保了处理器在其标称频率下的可靠性。
逻辑内建自测试技术代表了芯片测试领域的重要范式转变,从依赖外部设备转向芯片自我诊断。通过将测试功能集成到芯片内部,LBIST不仅降低了测试成本,还实现了传统方法难以企及的高速测试和现场监控能力。尽管存在覆盖率盲点、面积开销等挑战,但通过持续的技术创新,LBIST仍在不断扩展其应用边界,为芯片的高质量和高可靠性提供有力保障。
对芯片设计与测试技术感兴趣的开发者,欢迎到 云栈社区 的 计算机基础 版块进行更深层次的交流与学习。