随着集成电路朝着更高性能、更小尺寸的方向发展,封装技术的重要性日益凸显。在众多封装形式中,扇入型(Fan-In)封装因其紧凑的尺寸优势,常被用于制备晶圆级芯片尺寸封装(WLCSP)。尽管从严格的技术演进路径来看,常规WLCSP并不属于最前沿的先进封装范畴,但在实际的大规模应用中,它仍然面临着一系列亟待解决的可靠性挑战。
传统WLCSP的痛点主要集中在几个方面:芯片正面的介电材料,尤其是在14nm以下先进工艺节点中常用的力学性能较弱的聚酰亚胺(PI),容易在热应力或机械应力下发生分层;晶圆在机械切割(Dicing)过程中,容易在芯片背面产生毛刺并引发侧壁微裂纹;此外,在后续的芯片拾取、放置以及表面贴装(SMT)工序中,脆弱的芯片也容易遭受机械损伤。这些问题在要求严苛的应用场景下被进一步放大,例如汽车电子领域中的先进驾驶辅助系统(ADAS)和发动机舱内部件,这些应用不仅要求封装体积小,还必须能在极端高低温循环下保持稳定。为了应对这些挑战,一种成本更高但可靠性显著提升的方案——5面或6面全包裹模塑型WLCSP,正受到业界的广泛关注。
6面模塑WLCSP的结构剖析
6面模塑WLCSP的核心改进在于,它通过模塑工艺将芯片的正面、背面以及四个侧壁全部包裹起来,为脆弱的硅芯片提供了全方位的机械与环境保护。下图清晰地展示了其内部结构。
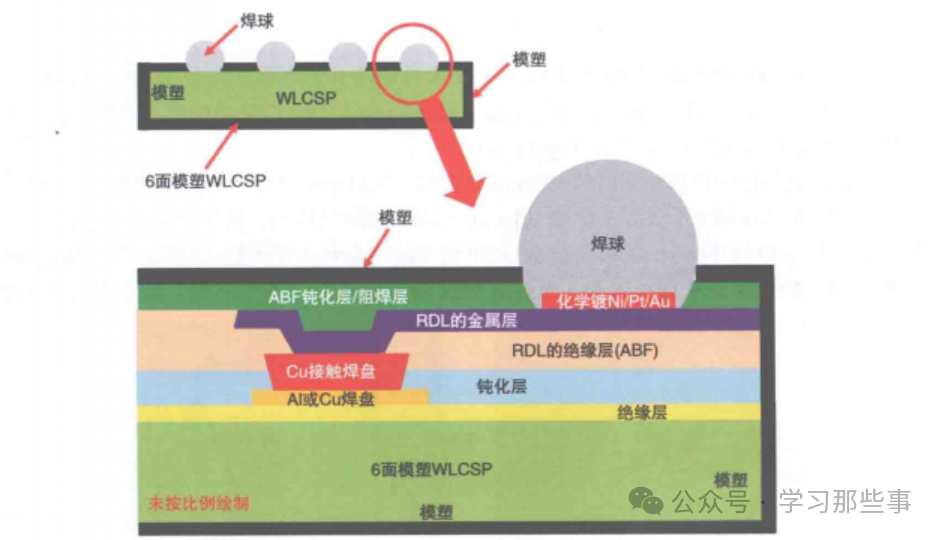
图1:6面模塑WLCSP结构剖面示意图。图中展示了焊球、模塑层、再布线层(RDL)、钝化层以及Cu/Al焊盘等关键结构,右侧放大区域显示了焊球连接的细节。
如图所示,封装内部包含一层关键的再布线层(Redistribution Layer, RDL),它由绝缘介质层(如ABF材料)和金属布线层构成,整体厚度约为20μm。RDL的线宽与线间距设计为20μm,而绝缘层的开窗尺寸则为50μm,这些精密的互连结构是实现芯片I/O端口重新排布、最终形成焊球阵列的基础。
为了更直观地对比,下图展示了三种不同WLCSP封装的外观与尺寸特征。
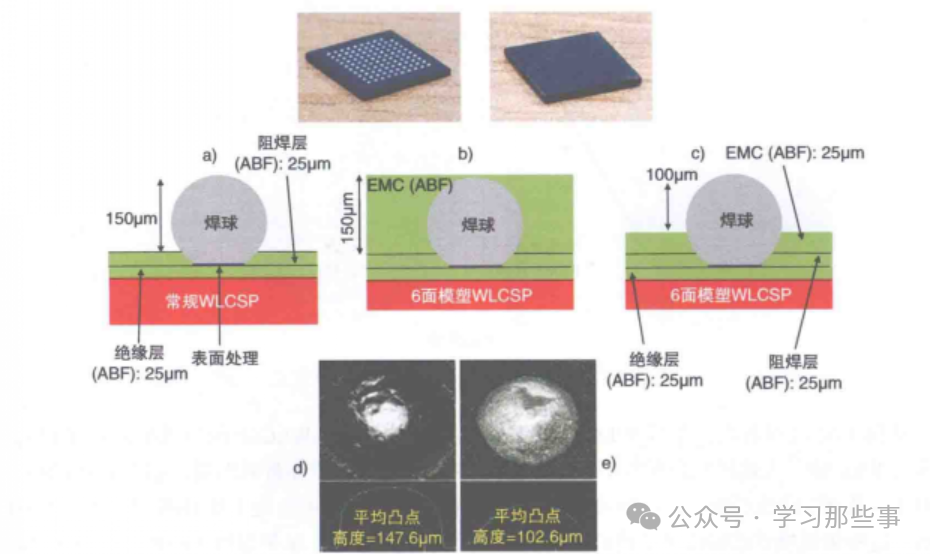
图2:常规与6面模塑WLCSP结构对比。(a) 常规WLCSP; (b) 6面模塑WLCSP; (c) 等离子刻蚀后的6面模塑WLCSP焊点; (d)(e)为对应的焊球高度测量图。
根据实测数据,6面模塑WLCSP的芯片侧壁模塑层平均厚度约为78μm,正面模塑层平均厚度约为53μm,焊球的平均支撑高度约为103μm(设计目标100μm),芯片本体厚度为390μm。作为对比,传统WLCSP的焊球平均高度为148μm(设计目标150μm)。这种尺寸上的差异直接影响了封装的整体机械与热学性能。
可靠性对决:常规型 vs. 6面模塑型
理论上的结构优势需要实验验证。研究人员将6面模塑WLCSP与常规WLCSP组装到PCB上,进行了-55℃ 至 125℃ 的严格温度循环(TC)测试。失效判据为菊花链电阻上升50%,并将首个焊点失效所经历的循环周期定义为该封装的失效寿命。
通过威布尔(Weibull)分布对测试数据进行分析,我们可以清晰地看到两种封装的寿命差异。

图3:常规WLCSP与6面模塑WLCSP的温度循环测试威布尔寿命分布对比。绿色曲线(6面模塑)的特征寿命远超蓝色曲线(常规)。
图3的曲线表明,6面模塑WLCSP的特征寿命达到了1037个循环周期,而常规WLCSP仅为368个循环周期。对于高可靠性要求的场合(如99.9%的幸存率),6面模塑型的平均寿命约为常规型的2.9倍。值得注意的是,两种封装最脆弱的焊点位置是一致的,都出现在焊球阵列最外侧、靠近芯片拐角处。
那么,它们的失效模式是否相同呢?通过截面分析,我们发现了根本性的区别。
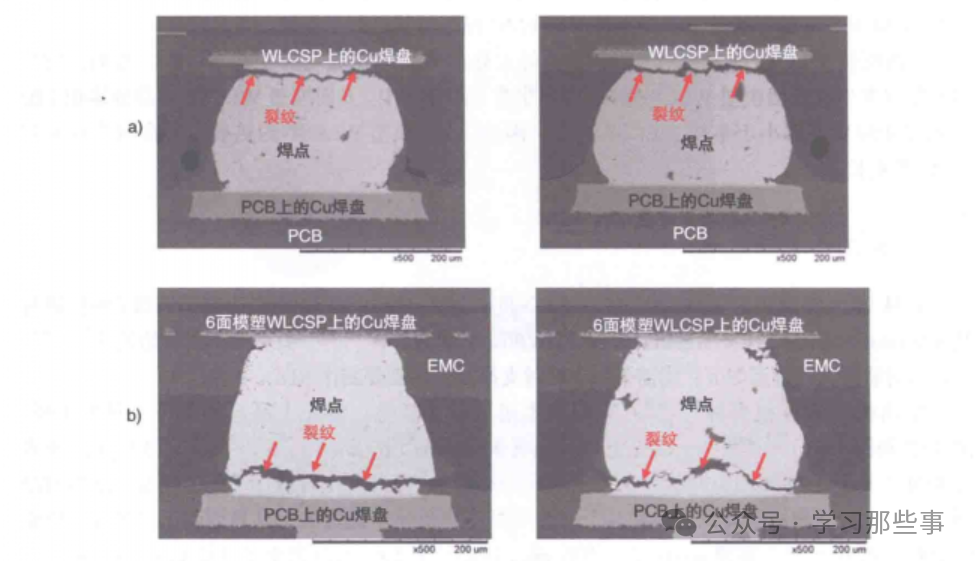
图4:失效焊点的截面显微图。(a) 常规WLCSP,裂纹位于芯片/RDL与焊料界面;(b) 6面模塑WLCSP,裂纹位于焊料与PCB界面。
如图4所示,常规WLCSP的失效发生在芯片/RDL层与焊料本体的界面处(芯片侧);而6面模塑WLCSP的失效则转移到了焊料本体与PCB的界面处(PCB侧)。这种失效位置的转移,是可靠性提升的关键信号。
失效机理与仿真验证
为什么6面模塑结构能改变失效位置?这需要通过深入的失效分析和计算机仿真来揭示。研究人员利用非线性有限元分析(FEA)对拐角焊点在温度循环下的应力应变进行了模拟。
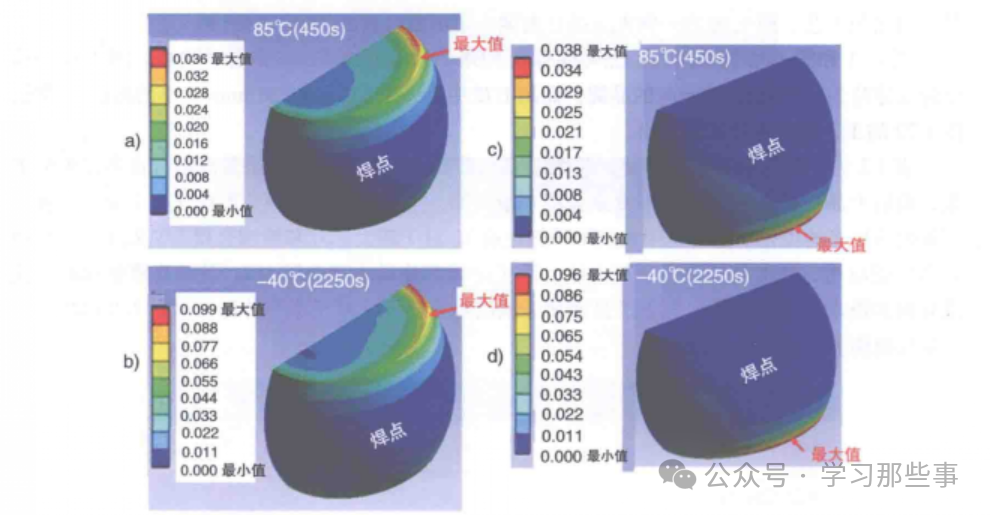
图5:温度循环下焊点累积蠕变应变云图。(a)(b) 常规WLCSP在85℃和-40℃下的应变分布,最大值在芯片侧界面;(c)(d) 6面模塑WLCSP在相同条件下的应变分布,最大值转移至PCB侧界面。
仿真结果(图5)完美印证了实验观察。对于常规WLCSP,最大的累积蠕变应变集中在芯片/RDL与焊料的界面;而对于6面模塑WLCSP,最大应变区域则转移到了焊料与PCB的界面。
其根本原因在于,6面模塑结构顶部的环氧模塑复合材料(EMC)为焊点提供了强有力的机械支撑和约束。它有效地抑制了焊料在芯片侧的形变,从而将应力和应变“推”向了约束相对更弱的PCB侧。虽然两种结构在拐角焊点处的最大应变值可能相近,但在6面模塑结构中,这个高应变区域被限制在极小的局部范围内,焊点大部分体积所承受的应变实际上低于常规结构。这正是6面模塑WLCSP热疲劳寿命更长、可靠性更优的内在机理。
总结与展望
综上所述,面对汽车电子等高端应用对扇入型封装提出的严苛可靠性要求,6面模塑WLCSP提供了一种有效的解决方案。它通过全方位的模塑保护,不仅提升了封装在制造和组装过程中的抗机械损伤能力,更重要的是,通过改变焊点内部的应力应变分布,将失效模式从脆弱的芯片侧界面转移至更可靠的PCB侧界面,从而实现了数倍于常规封装的热循环寿命。
这项技术是先进封装与材料力学相结合的典型范例。它不仅仅是一种工艺改进,更是对封装可靠性失效物理的深刻理解和应用。随着芯片集成度不断提高和应用场景日益复杂,这类基于深层机理分析的结构创新将在未来封装技术发展中扮演越来越重要的角色。对封装工程师和失效分析工程师而言,理解这些基本原理对于优化设计、解决问题至关重要。
如果你对芯片封装、可靠性测试等底层技术有更深入的兴趣,欢迎在技术社区如云栈社区参与讨论,与更多同行交流经验与见解。