在光学光刻中,随着特征尺寸不断逼近曝光波长,传统二元掩模因光的衍射效应导致图像边缘模糊、对比度下降,难以形成清晰图形。相移掩模(Phase Shift Mask, PSM) 正是在这种困境下诞生的关键技术。它通过在掩模的特定区域引入精确控制的相位差,巧妙地利用光的干涉效应来实现分辨率增强。其核心思想是让相邻光波产生180度相位差,在相遇处发生相消干涉,使光强降为零。这样一来,就从物理上“创造”出了清晰的暗区,极大锐化了明暗边界,最终显著提升图像对比度和焦深。
技术原理
传统二元掩模由透光区(石英)和不透光区(铬)组成。当光通过紧密相邻的开口时,衍射会导致光波散开并相互干涉,在晶圆平面上形成模糊的图像。相移掩模的解决方案,便是在特定区域引入180度相位偏移。当两束相邻光波存在180度相位差时,相消干涉使它们之间的光强骤降为零。这一物理效应能够显著提高分辨率和焦深,而且这种改善效果与曝光波长及抗蚀剂技术无关。

如果从波动光学的视角来审视,掩模图形可以用透过率 T 与相位 Φ 来共同描述。设想一下,对于两个相邻的狭缝,若它们的透射光相位相同,则振幅会相互叠加,最终融合成一个无法分辨的单峰。而在交替型PSM上,相邻狭缝存在180°相移,它们的复振幅会相减,导致两者之间的强度分布降为零,这两个狭缝因此可以被清晰地分辨出来。在傅里叶空间中,交替型PSM使衍射光的周期加倍、衍射角减半。更有趣的是,此时0级光(即所有区域的平均透射振幅)消失了,只剩下正负一级光通过投影物镜的光瞳并发生干涉,形成了与掩模图形周期完全相同的干涉条纹。
主要类型
相移掩模大体上可以分为强相移和弱相移两大类。强相移掩模由两个不同相位值的全透光图形(T=1,Φ=0°/180°)与不透光图形(T=0)构成。而弱相移掩模则包含半透明图形(0<T<1),该区域相对于全透光图形存在180°的相移。
1. 强相移掩模:交替型相移掩模
交替型PSM(例如 Levenson 型)在处理密集线条或空间图案时,会让相邻的透光区域交替具备0°和180°的相位,从而迫使所有透光区域之间发生相消干涉,实现频率倍增。它的分辨率提升效果最为显著:配合 I-line(365nm)光源可达到0.18μm,而结合 DUV(248nm)光源则能实现0.08μm的工艺节点,并且在特定条件下能提供最大的焦深。然而,交替型PSM并非完美无瑕,它面临着一个棘手的“相位冲突”问题——那些具有不同相位值的透光区域的过渡位置,会产生多余的光刻胶线条。工业界的实际解决方案是采用修剪掩模进行多次曝光:先用交替型PSM曝光来定义关键图形,再利用一个二元“修剪掩模”去移除相位变化处产生的不期望图形。当然,这种方法也带来了成本和工艺复杂度的增加。
无铬相移掩模(CPL)则是一种特殊的强PSM,它所有区域都透光,仅仅对相位进行空间调制(0°/180°交替)。这种设计巧妙地规避了相位冲突问题,并且由于没有光吸收层,其像强度会高于交替型PSM。无铬PSM尤其适用于曝光较细的线条,例如晶体管的栅极。它的掩模误差增强因子小,对掩模尺寸偏差不敏感,但制造成本高,检测难度也极大,需要依赖严格的电磁场仿真来量化三维掩模效应。
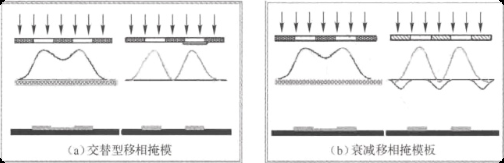
2. 弱相移掩模:衰减型相移掩模
衰减型PSM采用部分透光的衰减材料(例如厚度为68nm、针对193nm波长的MoSi)来取代传统不透光的铬层。这种材料既能够衰减光强(典型透光率在6%-30%之间),又能巧妙地引入180°的相位偏移。其最大优势在于通用性强,几乎可以直接用于大多数现有的图形设计,其制造流程也因此更接近传统的二元掩模。与标准的6% PSM相比,高透射率(30%)的衰减PSM能够显著提升归一化图像对数斜率,降低掩模误差增强因子(MEEF),并增加高达50%的焦深。不过,它的主要劣势在于存在“侧瓣打印”风险,即在不该有图形的地方,因光强的意外干涉而产生了多余像点。这个问题通常需要通过光学邻近效应校正等技术来抑制。将衰减型PSM与离轴照明组合使用,可以改善密集线空图形及孤立接触孔的工艺窗口。在确定最佳透过率时,工程师们必须在改善成像特性与控制旁瓣印出风险之间进行折中考量,因为旁瓣风险会随着背景透过率的增加而变大。
此外,业界还针对特定应用场景开发了多种新型PSM。例如棋盘格PSM,它专门针对接触孔阵列,通过棋盘式的相位排列来提升光学效率。还有EUV衰减PSM,它旨在优化吸收体材料的复折射率,以提升图像对比度并减轻掩模三维效应。
制造工艺与挑战
PSM的制造远比传统掩模复杂,其核心挑战在于如何对相位差进行精确控制。主要的工艺路径包括减成法(通过刻蚀石英基板或沉积介质层来形成相位差)和加成法(在图案化后的铬层上沉积介质层,然后进行二次图形化)。实现180°相移所需的刻蚀深度,是由掩模基底(石英)与下方材料(空气或真空)的折射率差所决定的。无论采用哪种方法,制造商都需要在性能、缺陷密度和成本之间做出权衡,而业界对此至今尚未形成明确的共识。
设计上的复杂程度、固有的相位冲突问题,以及为解决问题而引入修剪掩模带来的多次曝光,都让交替型PSM的成本急剧攀升。而衰减型PSM则需要严格控制吸收层的透过率和相位,这意味着要采用特定的折射率 n、消光系数 k 和厚度的参数组合。另外,相移层的引入也让缺陷检测与修复的工作变得前所未有的困难。
如今,PSM正与计算光刻技术深度融合。它的设计与光学邻近效应校正、光源掩模协同优化等技术紧密绑定,以期最大化地发挥其效能。在EUV光刻领域,低折射率衰减PSM等新型方案,正被视为扩展0.33 NA EUV至28nm节距以下最富前景的技术之一,用以提升图像对比度和工艺窗口。与此同时,面向高数值孔径(High-NA)EUV系统的研究也在持续推进,旨在优化PSM,以应对更高数值孔径带来的新挑战。
如果你想和更多同行一起深入探讨半导体技术,也可以来云栈社区看看,那里聚集了不少芯片领域的技术人。