
在半导体芯片制造的宏大工程中,光刻无疑是定义电路图形的核心工艺,而光刻胶则扮演了图形转移的“灵魂介质”角色,常被称为“半导体的液体黄金”。本质上,它是一种对特定光源敏感的混合液体,能够在紫外光或极深紫外光(EUV)等辐射下发生精确的化学性质改变,从而在硅片上复制出微米甚至纳米级别的电路图案。理解光刻胶,是深入现代微纳制造技术的关键一步。
光刻胶的分类
根据曝光、显影后的图形与掩膜版的关系,光刻胶主要分为两类,其选择直接决定了最终图形的特性。
- 正性光刻胶
在曝光前,它对显影液基本不溶。但当其被特定波长的光照射后,曝光区域的化学结构发生变化,变得可溶于显影液。因此,显影后留下的图形与掩膜版上遮光(不透光)的区域一致。由于通常能实现更高的分辨率和更佳的图形保真度,正性光刻胶是目前集成电路制造中的主流选择。
- 负性光刻胶
其特性与正胶相反。在曝光过程中,受到光照的区域会发生交联反应,变得不可溶;而未曝光的部分则在显影步骤中被溶解去除。因此,最终留在基板上的图形与掩膜版上透光的区域相同。虽然在某些特定应用(如部分 MEMS 或显示面板制造)中仍有使用,但由于显影时可能发生的溶胀变形问题,其在先进制程芯片中的使用已不如正胶普遍。

光刻胶的成分及其作用
光刻胶不是单一物质,而是一个精密的化学配方体系,每种组分都承担着特定功能。
- 感光树脂
这是光刻胶的骨架和主体,占比最大(通常60%-90%)。它决定了胶膜的基本物理化学性能,如硬度、柔韧性、与基底的附着力、耐热性以及最关键的一点——曝光前后在特定溶剂中溶解度的变化程度。树脂的分子结构和官能团设计直接关系到光刻胶的最终分辨率、对比度和抗蚀刻能力。
- 光引发剂
光刻胶的“开关”和“放大器”。它负责吸收光能,并将其转化为引发树脂发生化学变化的活性物质(如酸或自由基)。根据反应机制,主要分为两种:
- 光致产酸剂 (PAG):吸收光子后产生强酸,这些酸在后续的烘烤步骤中作为催化剂,触发树脂发生脱保护等连锁反应,从而大幅改变其溶解性。这种“化学放大”效应显著提高了光刻胶的灵敏度,是 KrF、ArF 和 EUV 等先进化学放大型光刻胶的核心。
- 感光化合物 (PAC):例如重氮萘醌类化合物。它在光照下发生结构重排,从原先的溶解抑制剂转变为溶解促进剂。这种非化学放大机制主要用于 g 线和 i 线等传统光刻胶中。

- 溶剂
为了让上述固态或高粘度组分能够被均匀地涂覆在硅片表面,需要溶剂将其溶解成液体。溶剂(如丙二醇甲醚醋酸酯,PGMEA)占光刻胶配方的绝大部分(70%-90%),它确保了胶液的流动性、稳定性和成膜质量,在涂胶后的预烘烤步骤中挥发。

- 单体/添加剂
这是一类功能各异的辅助成分,用于精细调节光刻胶的性能。
- 单体:也称为活性稀释剂,参与光聚合反应,可以调整胶膜的最终交联密度和机械性能。
- 添加剂:可能包括表面活性剂(改善涂布均匀性)、稳定剂(防止存储时性能衰减)、染料(控制光吸收)、碱(中和扩散的酸,控制图形轮廓)等。这些成分虽然占比小,但对工艺窗口和图形质量的影响至关重要。
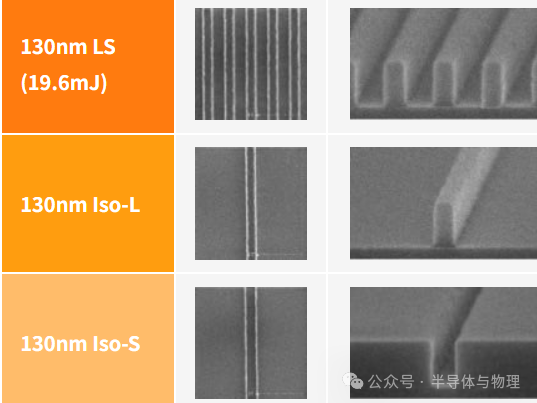


光刻胶的工作原理与工艺步骤
光刻胶的核心作用是通过其感光特性,将掩膜版上的二维设计图形转移到三维的硅片表面。这个过程涉及一系列严谨的物理化学反应,是现代精密制造的代表。如果你想深入了解整个光刻工艺的完整流程,可以阅读这篇详细的介绍:芯片制造:光刻工艺原理与流程。这里我们结合光刻胶的状态变化,简述关键步骤:
-
涂胶
硅片被固定在高速旋转的托盘上,光刻胶液体通过喷嘴滴在中心。在旋转产生的离心力作用下,胶液被均匀甩开,形成一层厚度高度均一、极薄(通常纳米到微米级)的胶膜。多余的胶液被甩离硅片。

-
软烘
涂胶后的硅片会在热板上进行低温烘烤(例如90-100°C),目的是蒸发掉绝大部分溶剂,使胶膜固化,增强其与硅片的黏附性,并稳定其感光性能。
-
曝光
这是图形转移的核心。特定波长(如248nm KrF激光、193nm ArF激光或13.5nm EUV)的光源,通过包含电路设计图形的掩膜版,照射到光刻胶上。
- 对于正性胶,曝光区域的光引发剂(如PAC或PAG)发生反应,使得该区域的树脂溶解度增加。
- 对于负性胶,曝光则引发树脂分子间的交联反应,使得该区域变得不溶。
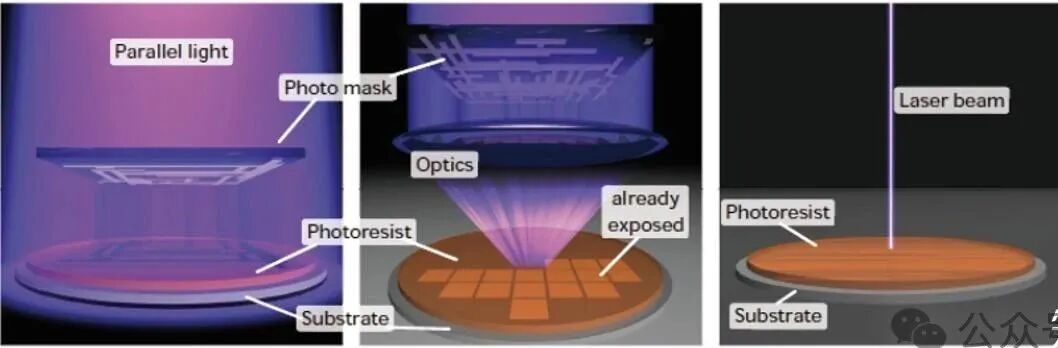
-
曝光后烘烤 (PEB)
此步骤主要针对化学放大型光刻胶。曝光产生的酸在热的作用下,在胶膜内横向扩散并催化树脂发生连锁的“脱保护”反应,从而将光信号化学放大,极大地提高了灵敏度。这一步对控制图形的关键尺寸(CD)和侧壁形状至关重要。
-
显影
将硅片浸入或喷淋特定的显影液(对于正胶通常是碱性溶液,如四甲基氢氧化铵 TMAH)。
- 正胶:曝光(及PEB后)变得可溶的区域被溶解掉,未曝光区域保留。
- 负胶:未曝光区域被溶解,曝光交联的区域保留。
这样,掩膜版上的图形就以“浮雕”的形式在光刻胶层上显现出来。
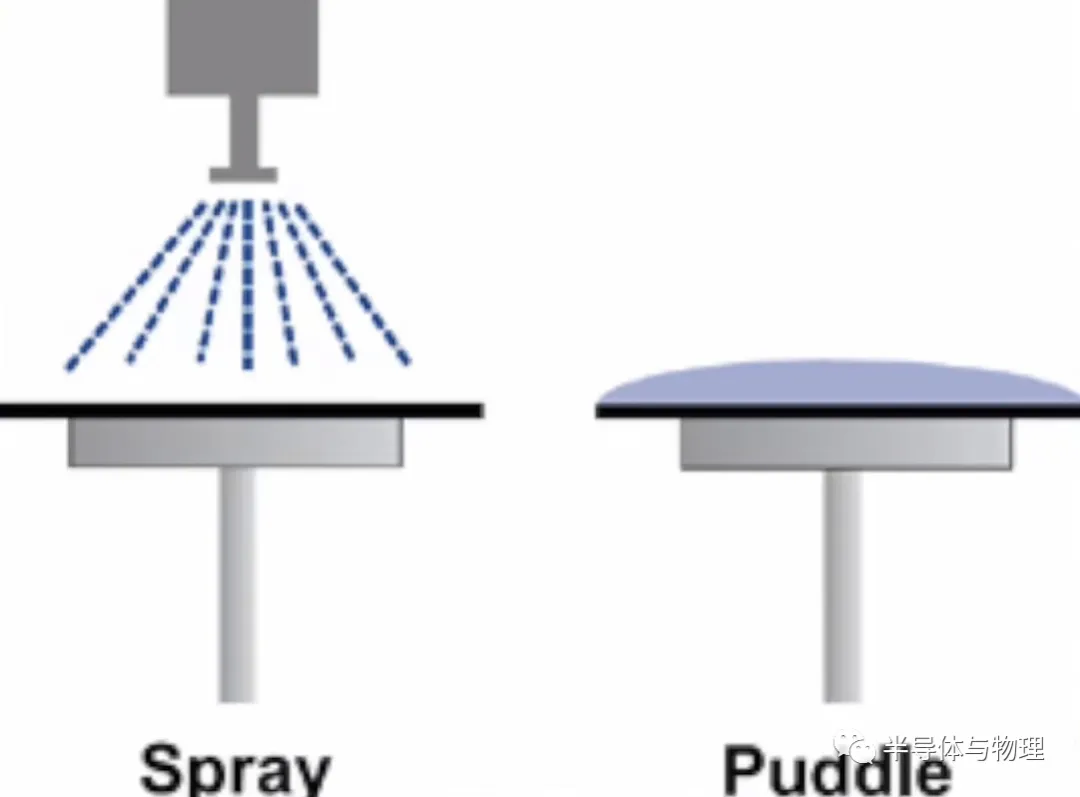
-
硬烘
显影后的最终烘烤。目的是彻底去除残留的溶剂和水分,进一步提高光刻胶的机械强度、耐蚀刻性和与基底的附着力,为后续的离子注入或刻蚀工艺做好准备。
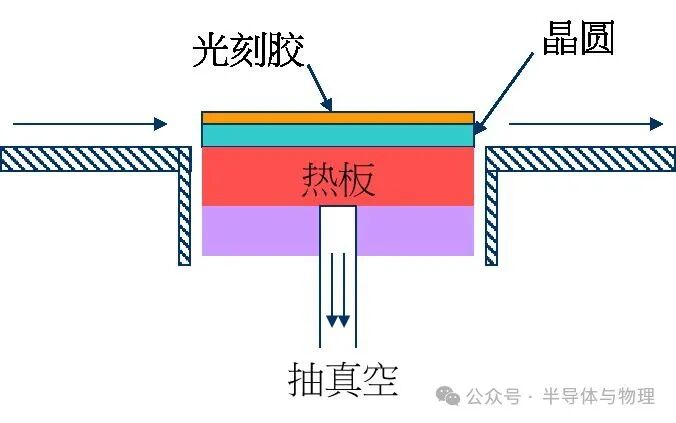
至此,光刻胶完成了它的核心使命——将设计蓝图转化为硅片上的物理屏障。接下来的刻蚀或离子注入工艺,将以这层胶膜为“模板”,对下方的硅基底材料进行加工,最终形成晶体管和互连结构。整个过程的精准控制,离不开对光刻胶成分、物理和化学性质的深刻理解与持续Optimization,这背后是化学、材料学、光学和精密工程等多学科的深度交融。如果你对支撑这些尖端技术的底层Computer Science与逻辑感兴趣,可以到 云栈社区 的基础板块进行更深层次的交流与探索。 |